Cosa ci è voluto per vincere il premio IRPS (IEEE International Reliability Physics Symposium) 2021 come miglior studio pubblicato?
di Fonte ST
Centinaia di migliaia di articoli scientifici compaiono ogni anno in pubblicazioni specializzate di ingegneria elettrica ed elettronica. Cosa ne rende uno migliore degli altri? Perché è emerso in particolare uno studio dedicato alla correlazione tra rottura dei MOSFET e difetti epitassiali 4H-SiC?
Quando l’IRPS 2022 ha aperto i battenti il 27 marzo, il suo contributo ha ricevuto numerosi riconoscimenti dagli organizzatori del simposio. Per scoprire come mai, il blog ST ha incontrato l’autore principale dello studio, Patrick Fiorenza, e alcuni dei suoi coautori, Santi Alessandrino, Fabrizio Roccaforte e Alfio Russo.
In poche parole, la ricerca ha messo in luce le relazioni recentemente scoperte tra alcuni difetti e la fattibilità dei dispositivi di potenza al carburo di silicio. È il prodotto degli sforzi congiunti tra ST e l’Istituto di Microelettronica e Microsistemi del Consiglio Nazionale delle Ricerche (Consiglio Nazionale delle Ricerche – Istituto per la Microelettronica e Microsistemi o CNR-IMM).
I due team condividono uno spazio nel sito della ST a Catania, in Italia, dove lavorano su carburo di silicio, nitruro di gallio, ecc. Cerchiamo quindi di esplorare come sono arrivati a questo documento pluripremiato e come ha già influenzato la prossima generazione di Dispositivi di alimentazione SiC attualmente in fase di sviluppo presso ST.

Filiere 4H-SiC non funzionanti
Il documento di ricerca indica due tipi di difetti: a breve termine e a lungo termine. Tra i primi, il più grave è il tipo t = 0 poiché non è funzionale fin dall’inizio. Lo studio è unico nel suo genere in quanto, per la prima volta, espone una relazione diretta tra difetti cristallini e tassi di guasto in t = 0 4H-SiCs. Come ben descritto in un post dedicato al carburo di silicio nelle automobili, il 4H-SiC è uno dei preferiti per le sue caratteristiche fisiche. Offre una migliore mobilità degli elettroni rispetto al 6H-SiC a 947 cm2/Vs, ma è più facile da produrre rispetto al 3C-SiC grazie alla sua struttura atomica di quattro doppi strati in un reticolo esagonale.
Come si è arrivati a questa scoperta?
Gli autori spiegano come hanno sfruttato la microscopia a forza atomica e le sezioni trasversali usando i microscopi elettronici a scansione per osservare t = 0. Quello che hanno trovato è la presenza di un precipitato cristallino, o, in termini comuni, una struttura che sembra una “roccia” nella parte inferiore dello strato epitassiale e misura circa 1,90 µm di altezza. In parole povere, la determinazione degli autori a capire perché questi dispositivi risultassero “morti all’arrivo” li ha portati a guardare più in profondità e scoprire una nuova relazione tra i precipitati cristallini e il tasso di difetti. Pertanto, il paper di ST e CNR-IMM ha ricevuto il premio perché ha esplorato i dies in SiC in un modo nuovo.
Che cosa ha ottenuto tale scoperta?
Dalla pubblicazione di questo documento, la ST ha imparato a ottimizzare la camera del reattore epitassiale e il processo di produzione dei dispositivi 4H-SiC. Pertanto, la ricerca dimostra come la passione per la comprensione della fisica alla base dei dispositivi 4H-SiC influisca sulle applicazioni del mondo reale. Infatti, grazie a questi risultati, ST può migliorare le rese e, quindi, realizzare dispositivi ancora più economici e durevoli.
Ci si può aspettare che i MOSFET di potenza 4H-SiC raggiungano in un numero ancora maggiore di mercati e applicazioni, contribuendo così ad aumentare l’efficienza energetica di dispositivi in tutto il mondo. Poiché le società affrontano crisi energetiche e sfide ambientali, la capacità di avere un impatto positivo sul consumo energetico di un prodotto rimane un obiettivo fondamentale.
Test di stress delle restanti dies 4H-SiC
Una volta vagliati i die t = 0, i ricercatori hanno messo quelli funzionanti in un pacchetto e li hanno sottoposti a stress test. La prima sfida è stata una sollecitazione di polarizzazione del gate ad alta temperatura, che ha aumentato il campo elettrico all’ossido del gate.
Il motivo per cui gli scienziati hanno spinto i dispositivi così duramente era per monitorare il comportamento in condizioni normali e difficili. È interessante notare che alcuni dei dispositivi mostravano già un comportamento anomalo a 3 MV/cm. Per capire come mai sia successo, hanno esaminato i monconi problematici al microscopio a forza atomica, che ha rivelato la presenza di protuberanze sull’ossido di gate di misura compresa tra 20 nm e 30 nm.
La scoperta ha rappresentato un punto di svolta in quanto ha aiutato a smistare i dispositivi che all’inizio sembravano funzionare correttamente ma che presentavano difetti quasi impossibili da individuare durante la produzione. Non solo il documento di ricerca ha spiegato perché i dispositivi avevano una conduzione del gate anomala, ma ha mostrato l’importanza del test di polarizzazione del gate ad alta temperatura. I risultati aiuteranno quindi le fonderie che cercano di monitorare meglio la qualità dei loro dispositivi SiC.
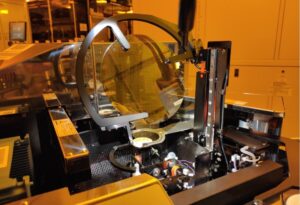
Quale polarizzazione inversa ad alta temperatura ha rivelato?
Dopo i primi stress test, i monconi sono stati sottoposti ad un’altra prova: una polarizzazione inversa ad alta temperatura. Il benchmark è durato tre mesi ed è servito a simulare decenni di normale utilizzo. In poche parole, ha aiutato gli autori a determinare se tutti i dispositivi si sarebbero comportati normalmente durante l’intero ciclo di vita. E mentre il 98% di loro lo ha fatto, l’altro 2% ha rivelato anomalie con correnti di gate sette volte superiori al normale.
In un’applicazione del mondo reale, tale comportamento rappresenterebbe un grave malfunzionamento. La sfida è che il difetto, coniato “killer silenzioso”, pur essendo sempre presente, si manifesterebbe solo dopo anni di normale utilizzo.
Gli autori hanno utilizzato per la prima volta un microscopio elettronico a scansione per capire cosa è andato storto, ma non sono riusciti a percepire nulla di anormale. Di conseguenza, sono passati alla microscopia elettronica a trasmissione, che ha rivelato la presenza di un difetto nel semiconduttore sotto l’isolante del gate.
Per capire meglio di cosa si trattava, gli autori hanno utilizzato la microscopia a forza atomica, che ha permesso loro di scoprire un difetto triangolare con un’altezza compresa tra 18 nm e 30 nm, a seconda della durata dello stress test. A questo punto, hanno compreso che c’era una dislocazione della filettatura dal substrato allo strato epitassiale. Di conseguenza, hanno utilizzato la microscopia a capacità di scansione per mostrare l’impatto fisico sul dispositivo MOSFET e spiegarne il comportamento elettrico difettoso.
È solo perché gli scienziati hanno utilizzato così tante tecniche investigative che sono stati in grado di capire cosa fosse successo. In parole povere, la dislocazione della filettatura colpisce la banda di valenza del dispositivo 4H-SiC, riducendone efficacemente il bendaggio. Come discusso altre volte, l’ampia fasciatura di SiC è responsabile delle eccellenti proprietà elettriche del dispositivo.
Qualsiasi fattore responsabile del suo restringimento, quindi, avrà un impatto negativo sulla struttura. In questo caso, la banda di valenza è aumentata di circa 0,8 eV fino a 1 eV, il che è significativo. Comparativamente, SiC ha un bendaggio che varia tra 2,3 eV e 3,3 eV, con 4H-SiC seduto a 3,23 eV.
Cosa ha ottenuto la collaborazione umana e perché è importante?
La capacità degli autori di utilizzare tanti strumenti investigativi deriva direttamente dalla solida e profonda collaborazione tra ST e CNR-IMM. Al di là dei risultati scientifici, il premio IRPS 2021 per il miglior studio pubblicato premia anche l’impresa umana.
Anni di interazione e il desiderio di apportare contributi significativi al settore hanno portato ST e CNR-IMM a condividere più di un semplice spazio di lavoro. La lezione che speriamo di condividere con questo presentazione è l’importanza di collaborare con istituti di ricerca, laboratori, ecc.
Immagine: wafer 4H-Si, STMicroelectronics












